半導体組立説明
弊社では半導体ウェハ・チップをご提供頂き、半導体の組立・パッケージング・試験検査を行っています。
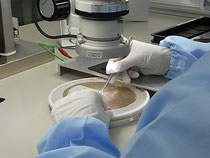
1.チップソーティング
バキュームピンセットや自動チップソーティングできない欠けクラックの発生しやすいチップを一つ一つ精密ピンセットにてつまみ取ります。

2.ダイボンディング
半導体セラミックパッケージにICチップを共晶結合します。
これも作業者による手作業です。
しかし位置精度としては50ミクロン以内にて実施します。

2-1.自動ダイボンディング
オートダイボンダーにてICチップを結合します。
マウンター兼用機となっており、位置精度としては
30ミクロンです。
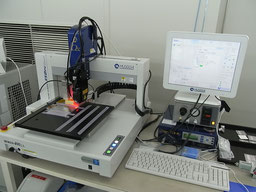
2-2.自動ペースト塗布装置
ICチップやチップ抵抗などの接合前に、
クリーム半田やAgペーストなどを自動で塗布します。
接合材だけでなく、液体の塗布は可能です。
(ポッティング材、コート材等)
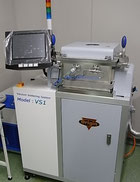
2-3.真空リフロー装置(ギ酸還元可能)
上記2-2接合剤を硬化させるためリフローを使用しますが、
当装置は加熱時真空状態にしボイドの発生を抑えます。
また酸化膜除去と濡れ性を良くする効果のあるギ酸還元機構が
付いています。
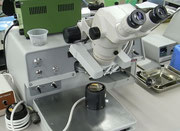
3.ワイヤーボンディング
チップパッド部よりアウターリードに対してワイヤーを接続します。
製品をお見せできないのが残念ですが、こちらも作業者によるマニュアル機と
自動ワイヤーボンダーがあります。

4.シーリング
パッケージ内部の組立が終わったら、蓋をします。
蓋をする方法もいくつかありますが、金属パッケージや
セラミックパッケージの場合シーム型溶接機にて実施する
のが一般的です。内部を真空にも出来ます。

5.リークテスト
きちんと蓋が出来たか確認するための試験です。
大きな穴が開いていないか、小さな穴が開いていないか?
ヘリウムガスを使用し確認します。
以上紹介した以外にも、パッケージ形状やお客様のご要望により
いろいろな組立装置、テスト装置がありますので
何なりと質問してください。
 My Jimdo-Page
My Jimdo-Page